TSMC lần đầu làm đóng gói chip AI tại Mỹ, hoàn thành năm 2030
TSMC đồng thời trang bị công nghệ đóng gói tiên tiến cho bảy nhà máy tại Đài Loan, đặt mục tiêu đạt 2 triệu wafer mỗi năm vào 2027, tăng từ mức 1,3 triệu wafer hiện tại.
TSMC đang đẩy nhanh mở rộng năng lực đóng gói chip tiên tiến, lên kế hoạch trang bị công nghệ này cho bảy nhà máy tại Đài Loan và hai cơ sở mới tại Mỹ, nhằm xử lý tình trạng thiếu hụt nguồn cung đang kìm hãm toàn bộ ngành AI.
Đóng gói chip tiên tiến là bước cuối trong quy trình sản xuất bán dẫn, nơi nhiều chip riêng lẻ được tích hợp thành một gói duy nhất để tăng hiệu năng và giảm độ trễ. Gần như toàn bộ ngành công nghiệp AI hiện nay đều phụ thuộc vào TSMC để thực hiện công đoạn này, khiến mọi điểm nghẽn về nguồn cung đều ảnh hưởng dây chuyền đến toàn bộ chuỗi cung ứng chip trên thế giới.
Theo báo cáo mới từ hãng thông tấn CNA của Đài Loan, TSMC đang chuẩn bị tăng tốc đầu tư mạnh mẽ vào lĩnh vực này. Công ty lên kế hoạch trang bị công nghệ đóng gói tiên tiến cho bảy nhà máy tại Đài Loan, bao gồm các công nghệ CoWoS, WMCM và SoIC, mỗi loại phục vụ phân khúc khách hàng khác nhau, từ smartphone đến các hệ thống điện toán hiệu năng cao. Trong số đó, nhu cầu từ mảng AI và điện toán hiệu năng cao lớn hơn nhiều so với các phân khúc còn lại, nên phần lớn công suất của bảy nhà máy sẽ được ưu tiên phục vụ sản xuất chip AI.

Mục tiêu 2 triệu wafer vào năm 2027
Đến năm 2027, TSMC dự kiến đạt công suất lên đến 2 triệu wafer mỗi năm trong mảng đóng gói tiên tiến, tăng đáng kể so với mức 1,3 triệu wafer hiện tại. Để tận dụng cơ sở hạ tầng sẵn có, TSMC còn xem xét chuyển đổi một số nhà máy sản xuất wafer kích thước 8 inch thế hệ cũ sang phục vụ cho đóng gói tiên tiến, một bước đi tiết kiệm chi phí hơn so với xây dựng nhà máy hoàn toàn mới từ đầu.
Hai cơ sở tại Arizona, hoàn thành vào năm 2030
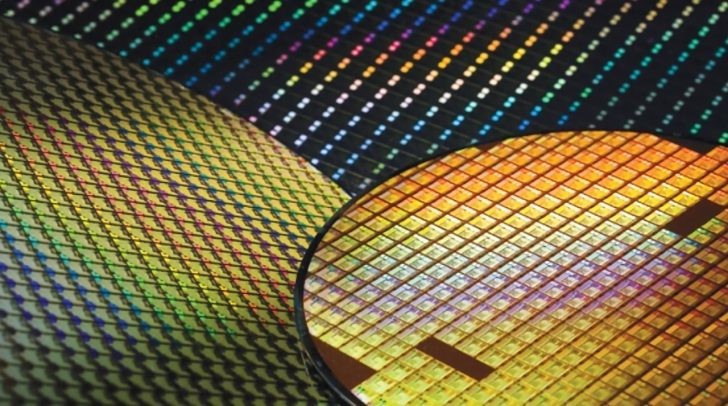
Song song với mở rộng tại Đài Loan, TSMC cũng đầu tư xây dựng hai cơ sở đóng gói tiên tiến tại bang Arizona, Mỹ. Hai cơ sở này dự kiến đi vào sản xuất hàng loạt vào năm 2030 và sẽ đóng góp một phần đáng kể vào tổng sản lượng toàn cầu. Hiện tại TSMC chưa có bất kỳ cơ sở đóng gói tiên tiến nào tại Mỹ đang hoạt động, điều này đang trở thành một trong những điểm nghẽn lớn nhất ảnh hưởng đến các nhà máy sản xuất chip của công ty tại nước này.
Mỗi thế hệ chip AI mới đều đòi hỏi các gói chip ngày càng lớn hơn và phức tạp hơn, khiến tầm quan trọng của đóng gói tiên tiến tăng theo cấp số nhân. Điều này giải thích vì sao TSMC liên tục phải chạy đua với nhu cầu thị trường và vì sao chậm trễ trong mở rộng công suất đồng nghĩa với nguy cơ mất khách hàng vào tay đối thủ.
Tình trạng thiếu hụt nguồn cung cũng đang thu hút sự chú ý vào Intel, khi công ty này đang phát triển các giải pháp đóng gói riêng của mình là EMIB và EMIB-T. Tuy nhiên, áp lực cung-cầu trên toàn ngành vẫn đang ở mức căng thẳng, và đợt mở rộng quy mô lớn của TSMC được xem là cần thiết để giữ vững vị thế độc tôn trong chuỗi sản xuất chip AI toàn cầu.
NỔI BẬT TRANG CHỦ
-

Bạn có đang là nạn nhân của chiêu trò "bắt cóc" nút Back? Google công bố án phạt nặng cho các web vi phạm
Google ấn định thời hạn 15/06 để trừng phạt các website sử dụng chiêu trò "bắt cóc" nút Back. Đây là chính sách mới của Google nhằm bảo vệ người dùng khỏi các bẫy quảng cáo rác và thao túng lịch sử trình duyệt.
-

AI chuyên đăng chuyện nhảm được tỷ phú công nghệ tặng 50.000 USD: 6 tháng sau, ví crypto của nó biến thành 40 triệu USD
